- 美国
- Scientific Computing International
- 干涉仪(115)
- 激光功率计(239)
- 单色仪(11)
- 光学延迟线(14)
- 光功率计(64)
- 光谱分析仪(104)
- 光波长计(35)
- 光谱仪(875)
- 激光雷达(29)
- 扫描仪和测距仪(24)
- 气体分析(47)
- 光学池(79)
- 光束分析仪配件(20)
- 光束分析仪(46)
- 激光能量计(82)
- 普通显微镜(60)
- 显微镜配件(25)
- 位移测量计(17)
- 计量配件(19)
- 光学表面轮廓仪(17)
- 孔探仪(39)
- 脉冲发生器(20)
- 太赫兹成像(4)
- 太赫兹时域(13)
- 其他分类测量仪器(19)
- 光纤检测工具(28)
- 脉冲诊断器件(30)
- 激光扫描和测距(9)
- 光束分析(5)
- 光学检测(14)
- 显微镜(12)
- 光纤测试与测量(3)
- 尺寸测量(1)
- 散热解决方案(20)
- Advanced Energy
- Advanced Scientific Concepts
- Aerotech
- Allied High Tech Products
- Ancal Inc
- Angstrom Inc
- Applied Analytics Inc
- Applied NanoFluorescence LLC
- Applied Research & Photonics Inc
- Applied Rigaku Technologies Inc Div of Rigaku Corp
- Bakman Technologies
- Berkeley Nucleonics Corp
- Bodkin Design and Engineering
- Brandywine Photonics
- Bridger Photonics Inc
- Capacitec Inc
- Capovani Brothers Inc
- Cargille Labs
- Carl Zeiss Microscopy LLC
- Cascade Technologies
- Catalina Scientific Instruments
- Complete Inspection Systems Inc
- Connected Fibers
- DFM Engineering Inc
- Direct Optical Research Co
- D&P Instruments
- Dunwell Tech
- 爱特蒙特光学
- Eltec Instruments Inc
- ENMET
- Femtochrome Research Inc
- Fischer Technology Inc
- Fort Wayne Wire Die Inc
- Luna Innovations
- GenScope
- GigaMat Technologies Inc
- GOW-MAC Instrument Co
- Gradient Lens Corporation
- Guided Wave Inc
- Highland Technology
- Idealab Inc
- Infinity Photo-Optical
- InPhotonics Inc
- Interferometric Optics
- International Light Technologies
- Intracellular Imaging
- ISS Inc
- JADAK, a Novanta Co
- JEOL USA Inc
- Kaiser Optical Systems Inc
- Kasalis
- L3Harris Technologies, Inc.
- Kiyohara Optics USA
- Laser Probe Inc
- Leica Microsystems Inc
- Lenox Instrument Co
- LI-COR Inc
- Lion Precision
- Logos Systems
- M3 Measurement Solutions
- Macken Instruments Inc
- Mad City Labs
- Martin Froeschner & Associates
- Max Levy Autograph Inc
- MBF Bioscience
- McBain Systems
- McPherson
- Mesa Photonics LLC
- Metrohm USA
- MicroVision Inc
- Midac Corp
- Montana Instruments Corp
- NANOVEA
- Nikon Instruments
- OAI
- OLIS Inc
- Ono Sokki Technology Inc
- Optical Data Associates LLC
- Optical Perspectives Group, LLC
- Optical Wavelength Laboratories
- Optimark Fiber Optics
- Optodyne Inc
- OptoKnowledge
- Optometrics
- OptoTech Optical Machinery Inc
- OptoTest
- OptoTherm Inc
- Optronic Laboratories Inc
- Pepperl & Fuchs Inc
- Photon Kinetics
- Physical Sciences Inc
- PI
- Ramco Innovations Inc
- Redondo Optics
- Reflex Analytical Corporation
- RWC Testing & Lab Supplies
- Scientific Computing International
- SICK Inc
- Spectra Services
- Spectraline Inc
- Star Tech Instruments
- Starna Cells Inc
- Sunrise Optical LLC
- Surface Optics Corp
- Taylor Hobson Precision
- Terasense Group
- The Microscope Depot
- Tiger Optics LLC
- Translume Inc
- TrueGage
- Unitron Ltd
- USA Borescopes
- VIEW Micro-Metrology
- Wilcom Inc
- Wilks - a Spectro Scientific Co
- World Precision Instruments
- WPI
- XIA LLC
- Zarbeco
- Zemetrics
- Pranalytica, Inc
- Pembroke Instruments, LLC
- Del Mar Photonics
- Photon Control Inc.
- 4D Technology
- AFL
- B&W Tek, Inc.
- BaySpec
- Bristol Instruments
- Broadcom
- 相干公司
- DeNovix
- Deviser Instruments
- Gamma Scientific
- Jonard Tools
- Keysight Technologies
- Leonardo Electronics US
- LIGHTEL
- MKS | Newport
- Ocean Insight
- OEwaves
- Optilab
- OSI Optoelectronics
- PerkinElmer Inc
- PIKE Technologies
- Pratt & Whitney Measurement Systems
- Precision Rated Optics
- Teledyne Princeton Instruments
- Quantum Composers, Inc.
- Special Optics
- Spectral Products
- Spectrolight, Inc.
- Spectrum Scientific, Inc
- StellarNet Inc
- Sutter Instrument
- TecOptics, Inc.
- Thermo Fisher Scientific
- 索雷博
- Titan Tool Supply
- Ultrafast Systems
- VEE GEE Scientific, Inc
- Verity Instruments, Inc.
- Vermont Photonics
- Viavi Solutions Inc.
- Wasatch Photonics
- Zygo Corporation
- Scientech Inc
- Altos Photonics, Inc.
- PureAire Monitoring Systems Inc
- QED Technologies Inc
- Solid State Cooling Systems
- Resonance
- DataRay
- Leonardo DRS
- 海洋光学
光电查为您提供3个产品。下载资料,获取报价,实现功能、价格及供应的优化选择。
-
 波长范围: 190 - 1700 nm 决议: 0.3-2nm 最短扫描时间: 0.2sec
波长范围: 190 - 1700 nm 决议: 0.3-2nm 最短扫描时间: 0.2secFilmTek™2000 PAR是一种低成本解决方案,用于开发和生产环境中的高通量、全自动图案化晶圆映射。该系统将获得专利的DUV-NIR反射计与晶圆自动加载器和模式识别相结合,在此价位上提供无与伦比的计量性能。FilmTek™2000 PAR采用SCI的专利抛物面镜技术,可测量从深紫外到近红外的波长,光斑尺寸小至13µm。该系统配备先进的材料建模软件,即使是较严格的测量任务也能实现可靠和直观。FilmTek™软件包括完全用户可定制的晶圆映射功能,可快速生成任何测量参数的2D和3D数据图。除了用户定义的模式外,标准映射模式还包括极坐标、X-Y、Rθ或线性。FilmTek™2000 PAR将SCI的广义材料模型与先进的全局优化算法相结合,可在每个站点1秒内同时确定多个薄膜特性。
-
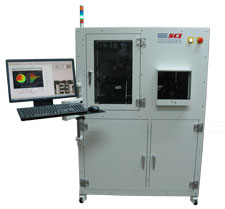 波长范围: 190 - 1700 nm 决议: 0.3-2nm 最短扫描时间: 1sec
波长范围: 190 - 1700 nm 决议: 0.3-2nm 最短扫描时间: 1secFilmTek™2000 PAR-SE组合计量生产线是我们较先进的台式计量解决方案,具有业内较高的准确度、精度和多功能性。FilmTek™2000 PAR-SE的设计旨在满足从研发到生产的几乎所有先进薄膜测量应用的需求。FilmTek™2000 PAR-SE结合了光谱椭圆偏振法和DUV多角度偏振反射法,具有宽光谱范围,可满足较具挑战性的测量需求。SCI的专利抛物面镜技术可实现低至50µm的小光斑尺寸,非常适合直接测量产品晶圆和图案化薄膜。FilmTek™2000 PAR-SE结合了专利多角度差分偏振(MADP)和差分功率谱密度(DPSD)技术,利用多角度偏振光谱反射计独立测量薄膜厚度和折射率。通过独立测量折射率和厚度,FilmTek™2000 PAR-SE对薄膜(尤其是多层堆叠中的薄膜)的变化比依赖于传统椭圆偏振或反射测量技术的现有计量工具更加敏感。FilmTek™2000 PAR-SE是一个完全集成的软件包,配有先进的材料建模软件,即使是较严格的测量任务也能可靠和直观地完成。硬件和软件都可以轻松修改,以满足客户的独特需求。
-
 波长范围: 240 - 1700 nm 决议: 0.3nm 最短扫描时间: 2sec
波长范围: 240 - 1700 nm 决议: 0.3nm 最短扫描时间: 2secFilmTek™2000 SE台式计量系统具有无与伦比的测量性能、多功能性和速度,适用于无图案的薄膜到厚膜应用。它非常适合学术和研发环境。FilmTek™2000 SE结合了光谱椭圆偏振法和DUV多角度偏振反射法,可同时测量薄膜厚度、折射率和消光系数。我们先进的旋转补偿器设计可在整个Δ(Δ)范围内实现精度和准确度,包括接近0°和180°。当无法在布鲁斯特条件附近进行测量时,这可以实现较佳性能,这对于硅或玻璃衬底上非常薄的薄膜的精确测量是必不可少的。数千个波长可在几秒钟内同时收集,集成的自动对焦功能消除了同类椭偏仪所需的手动样品对准的繁琐任务。FilmTek™2000 SE是一个完全集成的封装,配有直观的材料建模软件,即使是较苛刻的测量任务也能简单可靠地完成。FilmTek™软件包括完全用户可定制的样本映射功能,可快速生成任何测量参数的2D和3D数据图。除了用户定义的图案外,标准贴图图案还包括极坐标、X-Y、Rθ或线性。
